铝掺杂的硅半导体中载流子含量的测定方法
一、Mott-Schottky曲线法
CS系列电化学工作站可用于半导体或钝化膜 Mott-Schottky 图的测试。通过在不同直流电位下分别叠加一固定幅值和固定频率的交流扰动信号,测得不同直流电位下的阻抗值,并根据阻抗虚部来计算耗尽区电容 Csc ,最后按公式(1或2)计算并绘制 Mott-Schottky 图,并据此计算半导体或钝化膜材料中的载流子浓度,确定材料半导体特征。
Mott-Schottky 公式:

式中, Vfb 为平带电位(flat band potential), Nd 和 Na 分别是施主(donor)和受主(accepter)载流子浓度, ε 为相对介电常数, ε0 为真空介电常数, A 为电极表面积, k 为 Boltaman 常数, T 为温度, e 为电荷电量。
Csc 可根据公式(3)计算
![]() (3)
(3)
其中 Z”为阻抗虚部, f 为正弦波频率。
阻抗-电位扫描介绍:
将电解池装置连接到 CS350 电化学工作站上,从 corrTest 软件中选择“电位扫描”测试方法,并按图1所示进行参数设置(仅供参考):

测试完成后,将数据文件(.Z60)导入到 Origin 进行数据处理,如图 2 所示。

图2. Origin 导入数据后的列表图
将上图中第 G 列的值设为 Csc-2,即(2πf*Z’’)2. 以 G 列为纵坐标,C 列为横坐标,即得 Mott-Schottky 图,如图 3 所示。
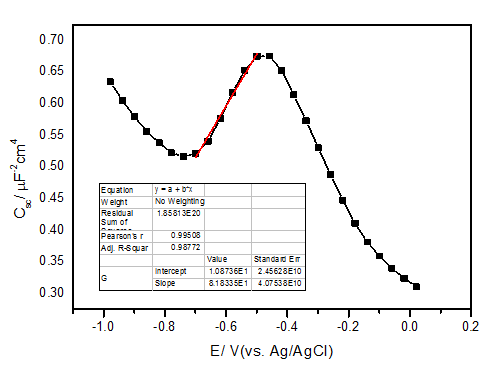
图3. 铝掺杂硅片半导体在 0.4 M KCL 中的 M-S 图(n 型半导体)
得到 M-S 图后,我们还需要对直线部分进行线性拟合,拟合后的斜率为  。对于 n 型半导体,其耗尽区的 M-S 曲线斜率为正,故对图 3 中的区域作拟合,即得拟合直线斜率。考虑到 CS 工作站在测量虚部阻抗 Z”时已经将面积考虑进去,因此电极面积的平方(A2)应该忽略,也就只有 Nd (载流子浓度)值为变量,其余全部为常量,所以有
。对于 n 型半导体,其耗尽区的 M-S 曲线斜率为正,故对图 3 中的区域作拟合,即得拟合直线斜率。考虑到 CS 工作站在测量虚部阻抗 Z”时已经将面积考虑进去,因此电极面积的平方(A2)应该忽略,也就只有 Nd (载流子浓度)值为变量,其余全部为常量,所以有  ( k 是所拟合得到的斜率)。斜率越大说明载流子浓度越低。
( k 是所拟合得到的斜率)。斜率越大说明载流子浓度越低。
二、ECV 法
电化学 C-V 法的基本原理是利用半导体材料与电解液接触形成的 Schottky 势垒代替传统 C-V 测量的金属-半导体接触, 并对半导体加以正向偏压( p 型)或反向偏压( n 型并加以光照) 进行表面腐蚀, 测量仪用电脑来控制, 数据采集软件能够在电容测量过程中改变测量偏压,这样就可以采用恒电流腐蚀法得到更精确的测量结果。ECV 法测量过程主要分为两步:第一步,测量电解液/半导体界面形成的 Schottky 势垒的微分电容来得到载流子浓度;第二步,利用阳极电化学溶解反应,按照设定的极化方法溶解测量处的样品。 不停地重复这一腐蚀-测量循环就可以得到载流子浓度与深度的关系。载流子的电荷密度为
 (4)
(4)
式中,ε 为相对介电常数, ε0 为真空介电常数, A 为电极表面积,e 是电子电量。dC/dV 是 C-V 曲线在耗尽区边沿的斜率。
该载流子浓度所对应的总深度为
x= Wd + Wr (5)
式中耗尽层的深度 (Wd) 可以由平板电容器公式给出, 即
 (6)
(6)
而腐蚀深度 (Wr)则按法拉第定律计算
 (7)
(7)
式中: M 是所测半导体的分子量; F 是法拉第常数; D 是所测半导体的密度; A 是电解液/半导体接触的面积; I 是即时溶解电流; Z 是溶解数(即每溶解一个半导体分子转移的电荷数)。
ECV 法所用方法介绍
ECV 法主要是测电化学电容与电压的关系,同样可以通过测阻抗-电位来计算。将图 2 中的 H 列的值设为 C,即 C = -1/2πfZ’’。以 C 为纵坐标,E 为横坐标作图,即得 C-V 图,如图 4 所示。
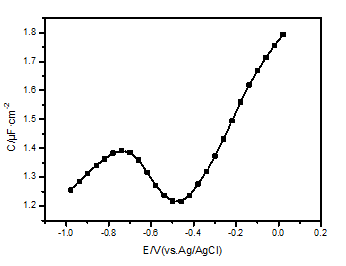
图4. ECV 法所测得 C-V 曲线
公式(4)中,dC/dV 为耗尽区的斜率,对 C-V 曲线(图4)求一次导数,即得各点斜率,即可得 dC/dV 的关系,如图 5 所示。
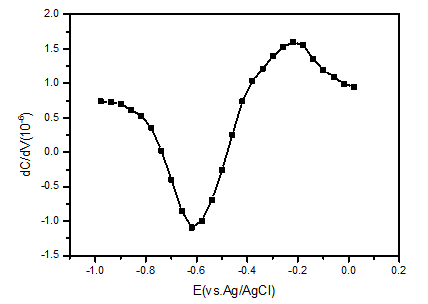
图5. dC/dV 关系曲线
三、电化学腐蚀方法介绍
根据半导体 n、p 型的不同,选择不同的正负偏压进行腐蚀,利用 corrTest 软件测试方法里的“恒电流扫描法”,可得到 即电量的值。根据公式(5)、(6)、(7)即可求得载流子浓度与腐蚀深度的关系。其中,不同材料的半导体应采用何种电解质溶液,腐蚀时的腐蚀电流与腐蚀时间,需要实验者进行优化。
即电量的值。根据公式(5)、(6)、(7)即可求得载流子浓度与腐蚀深度的关系。其中,不同材料的半导体应采用何种电解质溶液,腐蚀时的腐蚀电流与腐蚀时间,需要实验者进行优化。
Copyright By © 2008~2026 武汉科思特仪器股份有限公司 版权所有 鄂ICP备07502907号-1 免责声明
- 友情链接


















